
광/전자 소자 분야에 특화된 Nitride 에피 웨이퍼를 공급해 드립니다.
질화물 반도체란 III-V 족 반도체로서 V족 원소로 질소를 이용한 반도체입니다. 질화알루미늄 (AlN), 질화갈륨(GaN), 질화인듐(InN)이 대표적인 것들입니다.
기존 반도체에 비해 ‘와이드 밴드 갭’을 가지며 갈륨, 인듐, 알루미늄의 농도를 변화시켜서 소자를 만들며 가시광선 영역을 대부분 커버합니다. 화학적으로 안정적이고, 물리적으로 우수하여 최첨단 소자 개발에 적용되고 있습니다.
에피 노하우를 갖춘 협력 업체들이 InGaN, AlGaN, InAlN 구조를 통해 UV, Blue LD, High Temperature/High Frequency HEMT, IR 의 분야에 적용되는 웨이퍼를 공급해 드립니다.
InGaN
InGaN/GaN Quantum wells 구조는 370 ~ 560 nm 파장대를 나타냅니다. 최신의 성장 기술이 적용된 웨이퍼는 우수한 성능을 발휘합니다. 웨이퍼 파장대의 오차는 10nm 이하입니다. 450nm 에서 PL 선폭은 15nm 수준입니다.
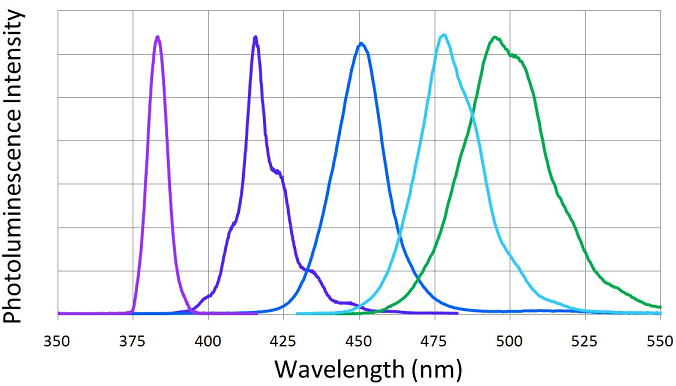

| Layers | Thickness(nm) | Doping |
| GaN | 150 | >5E17 |
| AlGaN / InGaN MQW | 80 | nid, Si: E18 |
| AlGaN | 2000 | E18 |
| AlGaN | 1000 | nid |
| AlN | 50 | nid |
| Substrate | 400um |
| Characteristics | Symbol | 420-430nm | 440-450nm | 440-450nm |
| Operating Mode | cw | cw | cw | |
| Output power (per facet) | Po | >100mW | >50mW | >10mW |
| Current Threshold (without coating) | lth | 30mW | <50mW | <80mA |
| Slope Efficiency (per facet) | ŋ | 0.7W/A | 0.5W/A | 0.3W/A |
| Epilayer | Unit | Thick InGaN Layer | InGaN/GaN QWs |
| Indium Content | % | 0 < In < 100% | 0 < In < 100% |
| Thickness | nm | 10 – 100 | 0.5 – 10 |
| Wavelength | nm | 370 – 1300 | 370 – 550 |
| n-type | cm-3 | 5E17 < n < 5E19 | 5E17 < n < 5E19 |
| p-type | cm-3 | < 5E17 | < 5E17 |
| Substrate | Sapphire, Si, SiC, GaN | ||
AlGaN
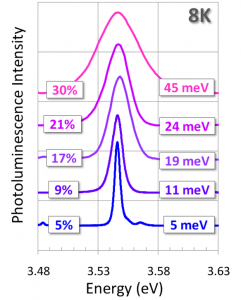
저희가 공급하는 Crack-free AlGaN Layer 기판은 완벽한 두께와 조성비를 요구하는 광/전자 소자 제작에 적합합니다. 공급해 드리는 헤테로구조의 웨이퍼는 UV LED, PD, 센서, 트랜지스터 등을 제작하는데 사용됩니다. 사용되는 기판은 사파이어, 실리콘카바이드, 실리콘, GaN 기판 등입니다. 이 밖에도 UV LED, Photo Detector, Sensor, Transistor 등에 사용되는 AlGaN 구조의 에피 웨이퍼를 공급해 드립니다. 일반적 Quantum Well에 있어 AlGaN 구조는 Al 구성 5 – 30% 를 유지합니다.
| Layers | Thickness(nm) | Doping |
| GaN cap | 2 | undoped |
| AlGaN Al:20% | 25 | undoped |
| AlN spacer | 1 | nid |
| GaN template | 2000 | E18 |
| Buffer | ||
| Sapphire, Silicon, SI-SiC | 400um |
| Epilayer | Unit | Thick AlGaN Layer | GaN/AlGaN QWs |
| Indium Content | % | 0 < Al < 100% | 0 < AI < 100% |
| Thickness | nm | 100 – 2000 | 0.5 – 15 |
| Wavelength | nm | 210 – 360 | 300 -380 |
| n-type | cm-3 | 5E17 < n < 5E19 | 5E17 < n < 5E19 |
| p-type | cm-3 | < 2E17 | < 2E17 |
| Substrate | Sapphire, Si (111), SiC, GaN | ||
AlInN
AlnN 레이어는 광/전자 소자 분야에서 최적의 효과를 나타냅니다. AlInN 는 단층 레이어에서 500nm에 이르는 두께까지 모든 기판에서 구현 가능합니다.
AlN/GaN 헤테로 접합구조는 HEMT에 최적화된 구조입니다.

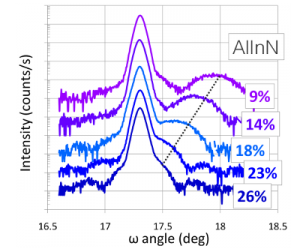
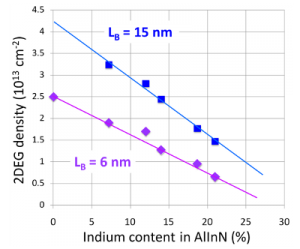
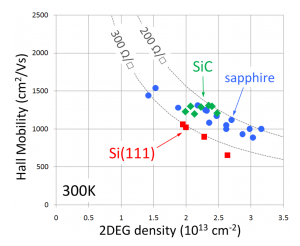
-2DEG Carrier Concentration: Ns=2.6×1013 cm-2,
-전자이동도1500 cm2/V/s ,
-Sheet 저항 200ohm/sqr (300K)
GaN보다 높은 굴절률과 밴드갭을 갖는 AlnN 구조는 전자소자뿐만 아래와 같은 광 소자 분야에 매력적으로 적용됩니다.
• UV와 가시광선영역에서 고성능의 레이저 다이오드 발산을 위한 웨이브 가이드
• 근 적외선 영역에서 GaN/AlInN 수퍼레티스 구조
• 고반사율을 갖는 UV, 블루와 그린 DBRs
• VCSELs을 위한 고품질의 Q Microcavities
• AlInN의 저 반사율로 인한 LED 구조에서의 Light extraction layer
• UV 광검출기와 LED 를 위해 고안된 Deep UV 헤테로구조
High Ns AlInN HEMT epiwafers
AlInN/GaN 헤테로 접합의 주요한 특징은 높은 전류 밀도를 구현할 수 있는 계면 전하밀도 (high interfacial sheet charge density)를 만들어 낸다는 것입니다. 2DEG-channel sheet charge density 자발 분극과 피에조 전기적 성질에서 나타난 2DEG-채널 표면 전하 밀도는 기존 AlGaN/GaN 헤테로 접합의 성질을 훨씬 능가합니다. AlInN Barrier 상에서 Al 조성을 조절하여Sheet Charge Density는 3×1013 cm-2 까지 도달 가능하며 최대 전류 밀도를 3 A/mm까지 나타냅니다. 고출력 파워소자를 위한 AlInN 헤테로접합에서 Indium 조성을 0 – 36% 까지 조절하여 고객이 원하는 목적의 구조에 맞게 제작하여 공급 가능합니다.
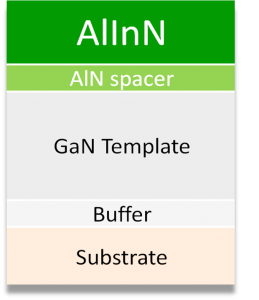
| Characteristics | Unit | Min | Typical | Max |
| AlIN Barrier Thickness | nm | 1nm | 10nm | 100nm |
| AlInN Barrier Thickness Variation | % | 0 | 0.25nm | 1nm |
| AlN Interlayer Thickness | % | 0nm | 1nm | 2nm |
| Indium Content in Al barrier | % | 0% | 18% | 36% |
| Sheet Density | cm-2 | 8.00E+12 | 2.40E+13 | 3.20E+13 |
| 300K Mobility | cmv-1s-1 | 800 | 1200 | 1500 |
| Resistivity | Ω/cm | 200 | 220 | 300 |
| Characteristics | Unit | Sapphire | Silicon | SiC |
| Sheet Carrier Density | cm-2 | 2.40E+13 | 2.00E+13 | 2.40E+13 |
| Mobility at 300K | cmv-1s-1 | 1300 | 1060 | 1300 |
| Square Resistance | Ω/cm | 200 | 300 | 200 |
| Maximum Current Drain | A/mm | 2.4 | 1.8 | 2.4 |
| Peak Transconductance | mS/mm | 520 | 335 | 480 |
| Maximum temperature for opeation | Tmax | 800 °C | ||
High Ns/Mobility material
2×1013 cm-2 를 초과하는 캐리어 농도를 갖는 HEMT 구조는, 2DEG 이동도 1000 – 1500 cm/Vs 를 나타내며 모든 기판에서 적용 가능합니다.
HEMT Sheet 저항은 상온에서 200ohm/sqr을 유지합니다. 이때 AlInN Barrier에서 Indium 조성은 13-26%를 갖습니다.
Al조성은 최소2DEG 이동도 1500 cm/Vs ( 300K) 를 능가합니다.
AlInN 의 성질은 GaN 에 Lattice Match되어 성장하여 스트레스가 없고, 우수한 자발 분극 (spontaneous polarization)효과를 나타낸다는 것입니다.
AlInN / GaN HMT 에피 웨이퍼는 Strain, Crack 없이 2DEG sheet carrier density 가 2.6×1013 cm-2 에 도달하며
Sheet 저항 200ohm /sqr 을 나타냅니다. 또한 AlGaN 2×1013 cm-2 수준에서 핀치 오프 전압을 5 V 이하로 유지합니다.

